高密度封裝指在一條基板上會有 2000 到 3000 顆獨立的芯片。這種封裝在 die bond 過程中通常會面臨點膠/畫膠的穩定性、RBO(樹脂溢出)、open time(點膠到裝芯片的停留時間)以及銀膏覆蓋率的挑戰。賀利氏研發團隊通過修改配方和工藝流程等方案克服了這些挑戰。本文將從這些方面佐證改善版的 DA295A 的有效性。
畫膠作業的穩定性:
參數設置:
●畫膠圖案:Double Y
●畫膠速度:70% (ESEC 2100)
●畫膠壓力:0.85 bar
產品結構:高密度基板,一條基板有3200多顆GaAs芯片需要貼裝。
測試方法:使用相同的參數連續畫膠
判斷標準:基于ESEC2100對膠形的檢測,客戶設定的規格膠型變化<25%

圖1連續作業的畫膠表現

圖2 連續作業的畫膠表現
一條基板3200多顆需要35分鐘左右完成,連續兩條基板需要70分鐘左右完成畫膠。
結論:如圖1和圖2 所示,改善版的DA295A能夠保持非常穩定的畫膠表現,平均波動在4%左右,遠小于客戶的要求25%。
樹脂溢出問題
RBO(樹脂溢出,Resin Bleeding Out)在烘烤過程中無法去除,也無法在wire bonding前的等離子清洗中完全清除,因此對打線和封裝會產生一定影響。賀利氏的ASP/DA295系列產品均采用無樹脂添加的溶劑配方體系,即全燒結配方體系(燒結完成后無殘留樹脂成分)。溶劑配方體系通常使用沸點較低的溶劑,在烘烤過程中達到沸點后溶劑將會揮發掉。在實際實驗中,不同的基板DPAD表面處理會導致不同程度的溶劑溢出,如下圖所示。圖3-1展示了較少的溶劑溢出,而圖3-2則顯示了接近100%的溶劑溢出。

圖3-1 溶劑溢出

圖3-2 溶劑溢出
溶劑溢出(Solvents bleeding out)在烘烤前后和等離子清洗后我們做了對比測試,如表1所示:

備注:顯微鏡的燈光影響了照片的顏色
表1溶劑溢出和揮發測試
結論:溶劑溢出在烘烤可以揮發掉,等離子清洗也可以提供雙重的保障。
Open Time(time interval between dispensing and die attach)
在高密度封裝中,畫膠后到芯片貼裝時燒結銀膏能夠維持多長時間而不發干的指標非常重要。一旦燒結銀膏發干,將會影響芯片的貼裝質量、貼裝后的銀膏覆蓋率,以及烘烤后的燒結強度,甚至可能導致在打線時出現芯片碎裂情況。
Open time測試:
選用常見的芯片尺寸(mm):0.74*0.70
測試條件,使用相同的畫膠參數以獲得一致的膠量,在同一時間畫膠,根據不同的時間間隔使用相同的參數進行貼裝芯片。
判斷標準:在BLT(Bond Line Thickness)在20~30um內,銀膏覆蓋率達到100%。

圖4 open time測試結果
結論:如圖4所示,改善版DA295A在芯片0.74*0.7的條件下可以到達60分鐘的open time;在90分鐘時通過調整裝片的距離也是可以達到100%的銀膏覆蓋。
燒結銀膏的覆蓋率
高密度封裝意味著在當前標準的基板尺寸內排列更多的個體單元,即減小焊盤尺寸壓縮芯片的貼裝面積。在高密度封裝中,芯片邊緣到焊盤的距離變得更小,例如有些產品設計了80~100um的距離,如圖5所示。
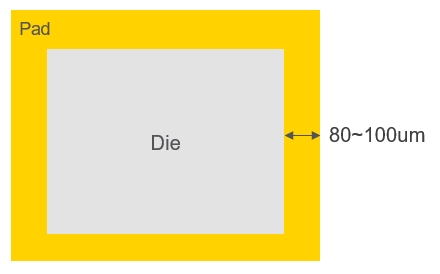
圖5 高密度的設計示意圖
這種高密度的設計對封裝工藝帶來挑戰,需要精確地控制燒結銀膏的體積,并同時實現100%的銀膏覆蓋率。相比常規產品,畫膠圖案的尺寸要小于芯片的尺寸。因此,對燒結銀膏的要求也更高,除了要具有穩定的作業性,還要求貼裝芯片之后達到100%的覆蓋率。
燒結銀膏覆蓋率:
測試方法:通過控制畫膠圖案的尺寸和裝片的高度,在裝片時控制銀膏的溢出。
檢測方法:在顯微鏡下檢查芯片底部銀膏覆蓋。
判斷標準:銀膏覆蓋率達到100%,且沒有超出焊盤。
在芯片貼裝后將基板取出,在顯微鏡下檢查發現芯片的四周都有均勻的銀膏覆蓋,完全滿足100%覆蓋率的要求,如圖6-1所示。

圖6-1顯微鏡下檢測結果
經過充分的驗證,改善版的DA295A在貼裝芯片后能夠達到100%的覆蓋率。針對一些高密度的緊湊設計DA295A是有效的解決方案。
可靠性測試
改善版的DA295A已通過多家客戶的作業性測試,并完成整個封裝流程。經過可靠性測試,具體數據見表2,SAT掃描未發現分層現象,電性能測試也通過。

表2可靠性測試結果
總結
1.改善版的DA295A具有穩定的作業性。
2.溶劑體系的配方在烘烤后溢出的溶劑能夠揮發掉,不會對打線鍵合產生影響。
3.較長的open time能夠滿足高密度封裝的需求,避免分段式作業。
4.能夠解決緊湊型設計的銀膏覆蓋率問題。
欲獲取更多信息,請聯系賀利氏電子。




